4H-SiC同质外延材料堆垛层错缺陷的表征与研究

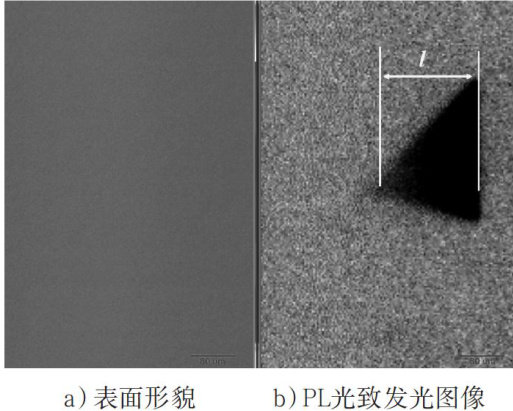
打开文本图片集
Characterization and Research on Stacking Faults and Defects of 4H-SiC Homogeneous Epitaxial Wafer
LU Weili FANG Yulong"LI ShuaiWANG QihengHAN MingruiWANG Bc (The 13th Research Institute of China Electronics Technology Group Corporation)
Abstract: The stacking faults and defects of SiCepitaxial materials grown bya horizontal single wafer epitaxial CVD reactorwasstudied.Thethickness anddefectsofSiCepitaxial materialswerecharacterized,tested,andstatistically analyzedusing theFourier transform infrared spectrometer and surface defect analyzer.The generation mechanism and extensionmodelofstacking faultsofSiChomogeneous epitaxialmaterials werestudied,andtheinfluenceofSiCsubstrate TSD and BPD dislocation density on the stacking faults density was researched.Through optimization of epitaxial temperatureand improvementof bufer layer process,thedensityofstacking faults inepitaxial materials was reduced to less than 0.1/cm2 . High-quality SiC epitaxial materials can further meet the needs of various SiC power electronic devices.
Keywords:SiC;epitaxy; defects; stacking faults
碳化硅(SiC)作为宽禁带半导体材料的代表,相较于传统硅材料,具有高10倍的击穿电场强度、高2倍的电子饱和速度、高3倍的禁带宽度和高3倍的热导率,尤其适用与制作高频、高压、大功率的SiC电力电子器件[-3]。(剩余5616字)