中、高温多层陶瓷基板共烧用导体浆料的研究现状及发展趋势

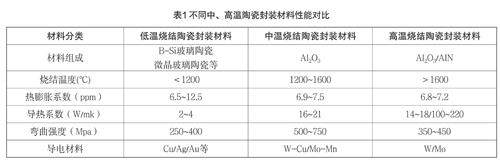
打开文本图片集
关键词:中、高温多层共烧陶瓷基板,导体浆料,导电相,填充相,粘结相
0 引言
近年来,随着国内航空航天、军工、消费电子、新能源汽车、5G等领域的快速发展,所需电子元器件内电路的密度和功能不断提高,人们对承载电子元件的封装技术提出的要求也越来越高。当前存在的电子元器件封装材料一般包括:陶瓷、塑料、金属以及金属基复合材料等,其中陶瓷材料因其密度较小,热导率较高,膨胀系数匹配,是一种综合性能较好的封装材料[1]。(剩余5095字)