考虑二元Copula统计量的晶圆制造叠加误差监测

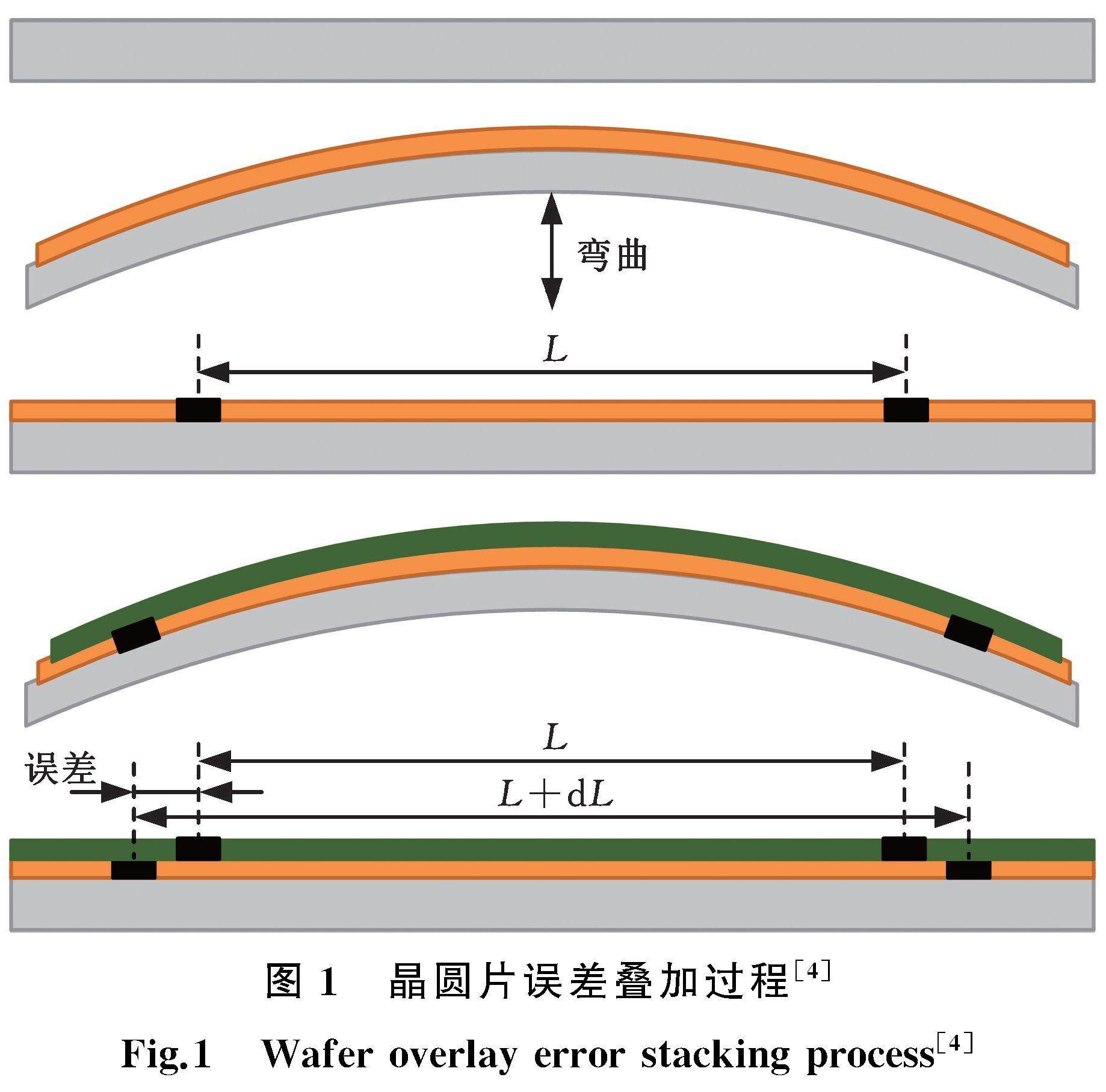
打开文本图片集
摘要:目前,大多数晶圆制造研究集中在基于离散数据的缺陷模式识别上,而芯片的光刻制造是连续叠加过程,因此基于连续数据的晶片重叠误差监测具有挑战性和必要性。在数据监测过程中充分考虑数据的可解释性,同时结合晶圆数据特性及其物理意义加入新的惩罚项,改进LTS-SPCA降维模型,提出了灵活度较高的稳健稀疏主成分分析技术;然后基于Copula的置换对称、反射对称两种性质,考虑晶圆的几何特征,建立了最佳多元耦合统计量,用于监测晶圆制造的叠加过程异常。(剩余13808字)